www.188betkr.com 讯随着电子器件的小型化和电子设备功率的不断增加,高密度封装器件的热管理问题面临越来越严峻的挑战。界面热阻对封装系统整体热阻的贡献很大,为增强器件的散热能力,热界面材料(TIM)被广泛应用于封装系统不同材料之间的界面,填补界面间的微小间隙,减少间隙中空气(导热系数仅为0.026W/(m·K))的影响。
在电子封装中,TIM通常应用于芯片与封装盖(TIM1)、芯片与散热器(TIM1.5)、封装盖与散热器之间(TIM2)。高导热性、高可靠性的TIM能够保障热量在界面的快速传递,避免因界面热阻过高带来的过热现象。
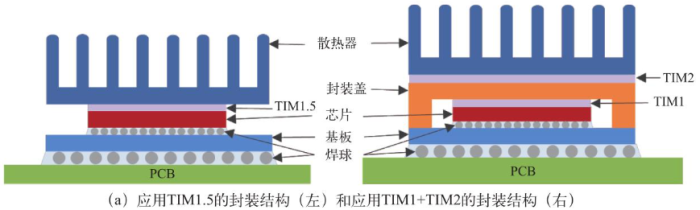
01 热界面材料组成
常用的热界面材料主要为填充型,主要是通过在聚合物基体中填充高导热的填料制备而成。通常情况下,聚合物基体的固有热导率都比较低(约为0.2W/(m·K)),因此,热界面材料的导热性能往往由填料说了算。填料设计优化是开发高导热TIM材料的重要方向,填料的种类、形状、尺寸均可以影响其在基体中导热网络的形成。
常见导热填料的热导系数

目前,常见的导热填料主要分为金属材料、陶瓷材料、碳类材料等。
金属材料:金属类填料遵循电子导热机理,具有热导率高、热稳定性能良好及热膨胀系数低等优点。常见的金属类填料包括银、铜、铝等,通常以粉末形式进行添加。
陶瓷材料:无机陶瓷类导热填料具有优异的导热性及电绝缘性,在电子封装领域具有独特优势。常见的无机填料主要包括氧化铝(Al2O3)、氮化硼(BN)、氮化铝(AlN)、碳化硅(SiC)、和氧化锌(ZnO)等。
碳材料:常见的碳类填料由碳的一系列同素异形体构成,包括石墨、金刚石、碳纳米管、碳纤维和石墨烯等。
02 热界面材料的关键特性
热界面材料的性能优劣,直接影响着电子设备的散热效果与整体性能。其性能主要由导热与热阻特性、稳定性等多个关键因素决定。
高导热系数。导热系数是衡量物质导热能力的关键物理量。它表示在稳定传热条件下,单位厚度、单位面积的材料在单位温差下、单位时间内传导的热量。导热系数越大,表明材料传导热量的能力越强,热量传递也就越迅速。
低热阻。热阻反映的是物体对热量传递的阻碍程度。它表示单位厚度、单位面积的材料在单位时间内传导的热量与通过该材料的热量之比。热阻越大,材料的导热性能越差,热量传递受到的阻碍也就越大。
高热稳定性。热界面材料需要在冷热循环条件下保持性能稳定,避免因温度变化导致的干涸、老化或性能下降。电子设备在实际使用过程中,会经历不同的工作温度环境,热界面材料的稳定性直接关系到电子设备的使用寿命和长期可靠性。
可压缩性与柔软性。热界面材料需要具备一定的可压缩性与柔软性,这样才能在较低安装压力下充分填充接触表面的微空隙。材料要足够柔软,以适应表面的不规则性,确保与发热元件和散热器紧密贴合。但又不能过于柔软,否则在压力下可能会被完全挤出界面区域,无法持续发挥导热作用。
表面浸润性。良好的表面浸润性是热界面材料的重要特性之一,它确保材料能够充分润湿接触表面,最大限度地减少界面处的接触热阻。对于液态或相变材料来说,这一特性尤为关键,它决定了材料在表面上的铺展能力和填充微空隙的效果。
粘性。适当的粘性可以使热界面材料临时固定散热器或发热元件,便于组装和后续处理。在电子设备的生产过程中,具有一定粘性的导热材料能够确保散热器在安装过程中保持稳定,避免移位。但粘性不能过高,否则在需要维修或更换设备部件时,会难以拆卸,甚至可能损坏设备。
03 常见的热界面材料
热界面材料的种类繁多,分类方式有很多种。一般按照导电性可将其分为绝缘型热界面材料和导电型热界面材料;按照组成可将其分为单组份热界面材料和双组份热界面材料;按照构成成分可将其分为有机型热界面材料、无机型热界面材料和金属型热界面材料;按照其特性差异及发展可分为导热硅脂、导热垫、相变材料、导热凝胶等。
(1)导热硅脂
导热硅脂是一种膏状热界面材料,由于它可直接减少接触面之间的空气间隙而具备优异导热特性而得到广泛应用,一般用作高功率电子器件散热。导热硅脂通常是将较高导热系数的无机填料与硅油基体进行混合脱泡加工而成。无机填料主要是Al、Ag等金属或Al2O3、AlN、BN、SiC、ZnO等陶瓷导热颗粒。

导热硅脂,图源:深圳市傲川科技有限公司
(2)导热凝胶
导热凝胶是一种粒子填充型聚合物,其基体材料硅树脂一般进行弱交联固化处理,以此来增强材料的内聚力。导热凝胶可兼具液体与固体特性,像液体一样分散,其特点是高导热性、低表面能和良好的一致性,在固化后可形成一个更坚实的结构,在保证低热阻的同时消除泵出效应问题,另外低模量特性也可吸收应力。

STGD系列导热凝胶,图源:广东思泉新材料股份有限公司
(3)导热垫
导热垫基体材料为有机硅树脂或聚氨酯,填料通常为Al2O3、BN等陶瓷或金属、石墨填料。为提高其强度,也可将玻璃纤维布作为载体。导热垫的柔韧性是非常重要的特点,高的导热颗粒填充体积分数可提高导热性能,但由此增加了其刚度,因此导热垫性能受限于高柔韧性和高导热颗粒填充率之间的矛盾。但由于导热垫具备减震性、无污染和便利性等优点,使其在一些热阻要求不是特别高的领域得到了非常广泛的应用。

导热垫,图源:上海阿莱德实业集团股份有限公司
(4)导热相变材料
导热相变材料同时具备导热硅脂和导热垫的优点,其基体材料的熔化温度基本位于室温和工作温度之间,使用时如导热膜一样便利,但在操作过程中会熔化并且能够贴合基板形成薄BLT厚度的导热油脂。也可使用熔化温度高于工作温度的相变材料,在这种情况下,热界面材料在加工过程中进行回流并在工作过程中保持固态。导热相变材料一般以石蜡、聚烯烃、低分子量聚酯等组成,再加上高导热的填料比如BN、Al2O3、AlN等来提高传热性能。

导热相变材料,图源:深圳市飞荣达科技股份有限公司
随着电子技术的快速发展,热界面材料的应用愈加广泛,需求量越来越高。根据BBC Research的报告,全球热界面材料市场规模已超过9亿美元,年增长率达7.4%。与国际领先水平相比,我国热界面材料行业起步较晚,但随着国内电子产业链自主可控需求日益迫切,以及5G通信、AI、新能源汽车等战略新兴产业的快速发展,本土企业正通过持续的技术创新,重点突破高导热性、超低热阻等关键性能指标,同时借助产业链协同创新提升产品性能和稳定性。在政策支持和市场需求双重推动下,我国热界面材料行业将加速实现国产化替代和高端化突破,不断提升市场竞争力。
参考来源:
胡妍妍等:高导热TIM的实现方法及其可靠性研究进展
杨宇军等:微电子封装热界面材料研究综述
王谦:集成电路先进封装材料
孙晓青:导热填料的研究进展与应用综述
车乾6G、热管理实验室ThermalLink
(www.188betkr.com 编辑整理/石语)
注:图片非商业用途,存在侵权请告知删除!






















