www.188betkr.com 讯随着人工智能、大数据、自动驾驶及高性能计算(HPC)等新兴技术的迅猛迭代,芯片算力需求呈指数级攀升,持续驱动系统封装向更高集成度、更大带宽与更低功耗的方向突破。传统封装模式在高速信号传输稳定性、电源完整性保障及高效热管理能力上逐渐显现短板,已难以应对当代芯片系统的多重技术挑战。
作为芯片与外部系统连接的核心互连载体,封装基板不仅是信号与电源传输的关键通道,其性能更直接决定了整个系统的运行效率、长期可靠性与封装密度上限。因此,研发具备超高布线密度、卓越电气性能与优异尺寸稳定性的先进封装基板,已成为突破下一代算力系统性能瓶颈、支撑高端芯片技术落地的核心环节。
玻璃基板技术由日本及美国的科研机构与材料企业率先提出,近年来,包括英特尔在内的领先厂商开始将玻璃基板作为突破封装密度与热管理瓶颈的重要路径之一,并推动其大尺寸化与量产工艺的发展。

不同基板核心层材料性能对比 来源:《玻璃基板技术研究进展》(赵瑾等)
玻璃基板封装有着一套严谨且精密的典型工艺流程,每一个环节都对最终产品的性能有着重要影响。首先是利用激光诱导等先进技术在玻璃的特定区域形成通孔结构,这些通孔将作为后续电连接的关键通道,其精度和质量直接关系到后续布线的稳定性。
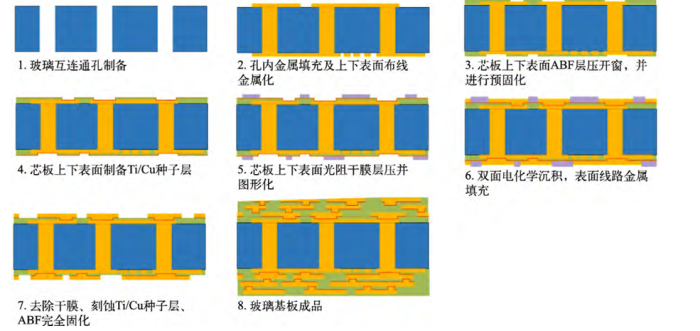
玻璃基板封装典型工艺流程 来源:《玻璃基板技术研究进展》(赵瑾等)
完成通孔制作后,便进入金属沉积与布线填充阶段。通过物理气相沉积(PVD)以及化学镀等方法,在玻璃表面以及通孔侧壁沉积金属种子层,为后续的金属填充奠定基础。随后,采用电镀工艺在通孔内部以及基板正反两面的布线区域填充金属,最终在芯层的上下表面形成两层金属布线层,这两层布线层是实现电信号传输的重要载体。
金属布线层形成后,流程推进到介质增层与焊盘暴露环节。在基板的两侧分别层压聚合物干膜(如ABF)作为介质增层材料,介质增层材料能够起到绝缘、保护的作用,同时也为后续的多层布线提供支撑。之后,通过开孔工艺将底部的金属焊盘暴露出来,这些暴露的焊盘将用于后续与芯片等组件的连接。
焊盘暴露完成后,开始进行多层布线的制作。通过种子层沉积、光刻图形化、电镀和去胶等一系列工艺形成新的金属布线,然后依次重复上述的介质增层、开孔、金属布线制作等步骤,逐步形成多层布线结构。这一过程能够实现基板上下表面与通孔之间稳定、高效的电连接,满足复杂电路的信号传输需求。
最后,为了保障基板在后续使用过程中的可靠性,需要在基板的正反面形成钝化保护层。钝化保护层可以有效隔绝外界环境中的水汽、杂质等对基板内部结构的侵蚀,提升基板的使用寿命和稳定性。同时,在保护层上进行开窗处理,露出最终的焊接焊盘,为后续芯片互连以及系统封装做好充分准备,确保玻璃基板能够顺利融入整个半导体封装体系。
纵观整个玻璃基板封装流程,其具备支持高密度多层布线与双面互连的能力。这种特性使其能够很好地满足先进封装对电性能的高要求,无论是信号传输的速度、稳定性,还是抗干扰能力,都能达到先进封装的标准。在未来,随着相关技术的不断成熟和成本的逐步降低,玻璃基板技术有望在半导体封装领域占据更加重要的地位,推动整个行业实现新的突破。
参考来源:
赵瑾.玻璃基板技术研究进展
张兴治.玻璃基板在芯片封装中的应用和性能要求
(www.188betkr.com 编辑整理/月明)
注:图片非商业用途,存在侵权告知删除!


















